下篇 LED封装技术岗位任务解析
第7章 LED封装概述
LED封装是将LED芯片粘贴固定在支架上,并将PN电极分别与支架的正、负极通过金线焊接方式或其他方式连接起来,最后通过封胶保证其内部结构的稳固性而形成LED灯珠成品的过程。对于采用荧光粉机理的白光LED,封装过程还必须包含配点荧光粉的过程。
LED封装属于LED产业链的中游,是一个工艺过程相对独立、岗位操作要求相对明确的生产过程,要求生产人员和技术人员在具备行业基本常识的基础上,掌握自动固晶机、自动焊线机、点胶机、自动分光机及自动编带机等几种典型封装设备的操作、调试和维护的岗位技能。这与上游的LED芯片制备领域的企业类似,区别是芯片制备的设备相对更加高级。下游的LED应用技术领域则更加强调员工的光机电技术的综合性和解决问题的能力。
本章首先介绍LED封装的基本常识,包括分类与工艺流程、原物料知识与产品命名、生产流程单的识读等;然后介绍LED封装环节中必须重视的防静电问题。
7.1 LED封装的分类及工艺流程
7.1.1 LED封装必要性及其分类
LED芯片只是一块很小的固体,它的两个电极要在显微镜下才能看得见,加入电流之后才会发光。在制作工艺上,除了要对LED芯片的两个电极进行焊接,引出正极、负极之外,还要对LED芯片和两个电极进行保护。这就需要对LED进行封装,即封装的最基本功能。
研发低热阻、优异光学特性、高可靠的封装技术是LED走向实用、走向市场的产业化必经之路。LED技术大都是在半导体分离器件封装技术基础上发展与演变而来的。将普通二极管的管芯密封在封装体内,作用是保护芯片和电气互连。LED封装是:实现输入电信号、保护芯片正常工作、输出可见光的功能,其中既有电参数的设计及技术要求,又有光参数的设计及技术要求。相比普通二极管封装,光参数的设计及技术要求是LED封装需要额外强调的地方,只有这样才能使LED的光品质更加优良。这是封装的扩展功能。
LED中,PN结发出的光子是非定向的,即向各个方向发射的几率相同。因此,并不是芯片产生的所有光都可以发射出来。能发射多少光,取决于半导体材料的质量、芯片结构、几何形状、封装内部材料和包装材料。因此,LED封装要根据LED芯片的大小、功率大小来选择合适的封装方式。
LED的封装方式包括:引脚式封装、平面式封装、表贴式封装、食人鱼封装、功率型封装,分别对应于第1章所述的LED按照灯珠封装方式分类的几种类型。
1.引脚式封装
引脚式封装即是制造直插式LED灯珠的封装过程,采用引线架作为各种封装外形的引脚,常见的有直径为5mm的圆柱形(简称Φ5mm)封装。
引脚式封装的工艺过程为:将边长为0.25mm的正方形管芯黏结或烧结在引线架(一般称为支架)上;芯片的正极用金属丝键合连到另一引线架上;负极用银浆黏结在支架反射杯内或用金属丝与反射杯引脚相连;顶部用环氧树脂包封,制成直径为5mm的圆形外形。其中,反射杯的作用是收集管芯侧面、界面发出的光,并向期望的方向角内发射。顶部包封的环氧树脂的作用:保护管芯等不受外界侵蚀;采用不同的形状和材料(掺或不掺散色剂),起透镜或漫射透镜作用,以控制光的发散角。
2.平面式封装
平面式封装LED器件是由多个LED芯片组合而成的结构型器件。通过LED的适当连接(包括串联和并联)和合适的光学结构,可构成发光显示器的发光段和发光点,然后由这些发光段和发光点组成各种发光显示器,如数码管、“米”字管、矩阵管等。
平面式封装即是制作LED数码管或点阵的过程。
3.表贴式封装
表贴式封装也称贴片式封装、SMD(Surface Mounted Devices)封装,这是制作贴片式LED灯珠的过程。
表面贴片LED是一种新型的表面贴装式半导体发光器件,具有体积小、散射角大、发光均匀性好、可靠性高等优点。其发光颜色可以是包含白光在内的各种颜色,可以满足表面贴装结构的各种电子产品的需要,特别是手机、便携式计算机。
4.食人鱼封装
食人鱼封装就是制作食人鱼LED的过程。
由于食人鱼LED所用的支架是铜制造的,面积较大,因此传热和散热快。LED点亮后,PN结产生的热量很快就可以由支架的四个支脚导出到PCB的铜带上。食人鱼LED比Φ3 mm、Φ5mm引脚式的管子传热快,从而可以延长器件的使用寿命。一般情况下,食人鱼LED的热阻比Φ3mm、Φ5mm管子的热阻小一半,所以很受用户的欢迎。
5.功率型封装
以上均是小功率的LED封装类型。近年来,随着大功率LED应用场合的不断拓展,许多大功率LED封装企业也应运而生。由于普通照明将是LED发展的下一个重要领域,因此,大功率LED是未来半导体照明的核心。大功率LED的特点:大的耗散功率、大的发热量、较高的出光效率、长寿命。
7.1.2 LED封装工艺流程
LED封装过程主要包括固晶、焊线、配粉(对白光LED)、封胶、分光与包装等工序。针对上述不同类型LED产品的封装方式,封装过程的工艺与设备相应也会有小的调整,但主要岗位的技术和工艺要求是大致相通的,单个灯珠的LED封装工艺流程及要点介绍如下。
1.芯片检验
芯片检验主要是用显微镜观察芯片的外观,检验其材料表面是否有机械损伤及麻点麻坑,检验芯片尺寸及电极大小是否符合工艺要求,电极图案是否完整等。
2.扩晶
由于LED芯片在划片后依然排列紧密、间距很小(约0.3mm),不利于后续工序的操作。
因此,必须先对黏结芯片的膜进行扩张,将LED芯片的间距拉伸到约0.6mm。扩晶一般采用扩片机进行半自动的扩片,也可以采用手工扩张,但很容易造成芯片掉落。
3.点(固晶)胶
在LED支架的相应位置点上银胶或绝缘胶(对GaAs、SiC导电衬底,背面电极上的红光、黄光、黄绿光LED芯片,采用银胶来固定芯片。对蓝宝石绝缘衬底的蓝光、绿光LED芯片,采用绝缘胶来固定芯片)。
银胶的好坏主要从黏稠度、热量传导率、固化条件来评估。点胶的工艺难点在于点胶量的控制,在胶体高度、点胶位置也有详细的工艺要求。由于银胶和绝缘胶在储存和使用时均有严格的要求,所以要特别注意它们的解冻、搅拌、使用时间。
4.备(固晶)胶
与点胶相反,备胶是用备胶机先把银胶涂在LED芯片背面电极上,然后把背部带银胶的LED芯片安装在支架上。备胶的效率远高于点胶,但不是所有产品均适用备胶工艺(备胶一般应用于数码管封装)。
5.手工刺片(手动固晶)
将扩张后的LED芯片(备胶或未备胶)安置在刺片台的夹具上,LED支架放在夹具底下,在显微镜下用针将LED芯片一个一个地刺到相应的位置上。与自动装架相比,手工刺片有一个好处,便于随时更换不同的芯片。手工刺片适用于要安装多种芯片的产品。
点胶和备胶两种操作通常是针对手动固晶而言的。
6.自动装架(自动固晶)
自动固晶是目前LED封装企业批量生产的主要固晶方式。
自动装架结合点胶和芯片检验两大步骤,先在LED支架上点上银胶(绝缘胶),然后用真空吸嘴将LED芯片吸起并移动位置,再安置在相应的支架位置上。在工艺上主要是熟悉自动装架设备操作编程,同时要对设备的点胶及安装精度进行调整。尽量选用胶木吸嘴,防止对LED芯片表面的损伤,特别是蓝色、绿色芯片,必须使用胶木吸嘴,因为钢嘴会划伤芯片表面的电流扩散层。
7.烧结(烘烤)
烧结的目的是使银胶固化。烧结时要求对温度进行监控,防止出现批次性不良品。银胶烧结时,温度一般控制在150℃,烧结时间为1.5h,也可根据实际情况调整到170℃、1h。绝缘胶烧结时一般为150℃、1h。
银胶烧结的烘箱必须按工艺要求每隔2h(或1h)更换烧结的产品,中间不得随意打开。
8.压焊(自动或手动焊线)
压焊的目的是将电极引到LED芯片上,完成产品内外引线的连接工作。
LED的压焊工艺主要是金丝球焊,还可采用铝丝压焊。铝丝压焊的步骤为:先在LED芯片电极上压上第一点;再将铝丝拉到相应的支架上方,压上第二点后拉断铝丝。金丝球焊的操作过程则在压第一点前先烧个球,其余过程类似。
压焊是LED封装技术中的关键环节,工艺上主要需要监控压焊金丝拱丝的形状(弧形),规定第一、二焊点形状大小,如金线拉力、大功率金线一般采用直径为1.2mil。
9.点胶封装
点胶封装工艺控制的难点是气泡、多胶、少胶、黑点,设计上主要是材料的选型。要选用结合良好的胶水和支架,SMD-LED和芯片模组LED适用于点胶封装。手动点胶封装对操作水平要求很高(特别是白光LED),主要难点是对点胶量的控制。白光LED的点胶封装还存在荧光粉沉淀导致光色差的问题。
10.灌胶封装
Lamp-LED、大功率LED的封装一般采用灌胶封装的形式。灌胶封装的步骤为:先在LED成型模腔内注入液态胶体;然后插入压焊好的LED支架,并放入烘箱让其固化;最后将LED从模腔中脱出即成形。
11.模压封装
模压封装的步骤为:将压焊好的LED支架放入模具中;将上、下两副模具用液压机合模并抽真空;将固态环氧放入注胶道的入口加热并用液压顶杆压入模具胶道中;环氧顺着胶道进入各个LED成形槽中并固化。
12.短烤、长烤
短烤是指封装胶水的初步固化。透镜封装固化条件一般为100℃、30min,模压封装固化条件一般为150℃、40min。
长烤是为了让胶体充分固化,同时对LED进行热老化。长烤对提高硅胶与支架(PCB)的黏接强度非常重要。一般固化条件为150℃、4h。
13.切筋、切脚和划片
由于LED在生产中是连在一起的(不是单个),所以直插式LED需要采用切筋工序切断LED支架的连筋。此外,还需要将灯珠正、负极的两个引脚切成正极长负极短的状态以示区分,这称之为切脚。负、正引脚的切脚分别称为半切、全切或一切、二切。
SMD-LED或大功率LED通常为多个支架在一片支架片上,需要划片机或拨料机来完成分离工作。
14.分光、测试与包装
测试LED的光电参数、检验外形尺寸,要根据客户要求对LED产品进行分选。目前,批量生产一般在自动分光机上进行。对不同类型的LED成品,采用不同的设备或容器进行包装以出厂或入库。
对小功率SMD产品,通常还要采用编带这种包装方式,这是在自动编带机上进行的。
封装是LED产业链的中游环节,我国LED封装环节的实力比较强,有各种规模的LED封装企业。
7.1.3 LED封装技术的发展
1.灯具的高品质对LED封装的要求
与传统照明灯具相比,LED灯具不需要使用滤光镜或滤光片来产生有色光,不仅效率高、光色纯,而且可以实现动态或渐变的色彩变化,在改变色温的同时保持其高的显色指数,满足不同的应用需要。为了使LED具有理论上的各种高品质特性,对LED的封装技术也提出了新的要求,具体体现在以下几点。
1)模块化
通过多个LED灯(或模块)的相互连接,可实现良好的流明输出叠加,满足高亮度照明的要求。通过模块化技术,可以将多个点光源或LED模块按照随意形状进行组合,满足不同领域的照明要求。
2)系统效率最大化
为了提高LED灯具的出光效率,除了需要合适的LED电源外,还必须采用高效的散热结构和工艺,以及优化内/外光学设计,以提高整个系统效率。
3)低成本
LED灯具要走向市场,必须在成本上具备竞争优势(主要指初期安装成本),而封装在整个LED灯具生产成本中占了很大部分。因此,采用新型封装结构和技术,提高光效/成本比,是实现LED灯具商品化的关键。
4)易于替换和维护
由于LED光源寿命长,维护成本低,因此对LED灯具的封装可靠性提出了较高的要求。要求LED灯具设计易于改进以适应效率更高的LED芯片封装要求,并且要求LED芯片的互换性要好,以便灯具厂商自己选择采用何种芯片。
2.LED封装的新技术
LED封装是一个涉及多学科(如光学、热学、机械、电学、力学、材料、半导体等)的研究课题。从某种角度而言,LED封装不仅是一门制造技术(Technology),而且是一门基础科学(Science),良好的封装需要理解和应用热学、光学、材料和力学等的物理本质。LED封装设计应与芯片设计同时进行,并且需要统一考虑光、热、电、结构等性能。在封装过程中,虽然材料(散热基板、荧光粉、灌胶封装)选择很重要,但封装结构(如热学界面、光学界面)对LED光效和可靠性影响也很大,大功率白光LED封装必须采用新材料、新工艺、新思路。对LED灯具而言,更需要集成考虑光源、散热、供电和灯具等性能。
为了达到以上要求,LED封装技术在经历了前述各种单个灯珠封装方式的不断优化或性能提高之后,进入一个更加高层次的技术平台,这个平台以提高LED最终产品性能为目标,并逐渐将LED技术各环节进行合理的融合。在此情形下,出现了各种新的封装技术。
1)板上芯片(COB)封装式LED封装
COB是Chip On Board(板上芯片)的英文缩写,是一种通过黏胶剂或焊料将LED芯片直接粘贴到PCB板上,再通过引线键合实现芯片与PCB板间电气互连的封装技术。PCB板可以是低成本的FR-4材料(玻璃纤维增强的环氧树脂),也可以是高热导的金属基或陶瓷基复合材料(如铝基板或覆铜陶瓷基板等)。而引线键合可采用高温下的热超声键合(金丝球焊)和常温下的超声波键合(铝劈刀焊接)。COB技术主要用于大功率多芯片阵列的LED封装,与表贴式封装相比,不仅大大加大了封装功率密度,而且减小了封装热阻(一般为6~12 W/m·K)。
2)系统封装(SiP)式LED封装
SiP(System in Package)是近几年来为适应整机的便携式发展和系统小型化的要求,在系统芯片(System on Chip,SOC)基础上发展起来的一种新型封装集成方式。对SiP-LED而言,不仅可以在一个封装内组装多个发光芯片,还可以将各种不同类型的器件(如电源、控制电路、光学微结构、传感器等)集成在一起,构建成一个更为复杂的、完整的系统。与其他封装结构相比,SiP具有工艺兼容性好(可利用已有的电子封装材料和工艺)、集成度高、成本低、可提供更多新功能、易于分块测试、开发周期短等优点。按照技术类型不同,SiP可分为四种:芯片层叠型、模组型、MCM型和三维(3D)封装型。
目前,高亮度LED器件要代替白炽灯以及高压汞灯,必须提高总的光通量,或者说必须提高可以利用的光通量。光通量的增加可以通过提高集成度、加大电流密度、使用大尺寸芯片等措施来实现。而这些都会增加LED的功率密度,如散热不良将导致LED芯片的结温升高,从而直接影响LED器件的性能(如发光效率降低、出射光发生红移、寿命降低等)。多芯片阵列封装是目前获得高光通量的一种最可行的方案,但是LED阵列封装的密度受限于价格、可用空间、电气连接,特别是散热等因素。由于发光芯片的高密度集成,散热基板上的温度很高,必须采用有效的热沉结构和合适的封装工艺。常用的热沉结构分为被动散热和主动散热。被动散热一般选用具有高肋化系数的翅片,通过翅片和空气间的自然对流将热量耗散到环境中。该方案结构简单,可靠性高,但由于自然对流换热系数较低,只适合于功率密度较低、集成度不高的情况。对大功率LED封装,则必须采用主动散热方案,如翅片+风扇、热管、液体强迫对流、微通道制冷、相变制冷等。
在系统集成方面,中国台湾地区新强光电公司采用系统封装(SiP)技术,并通过翅片+热管的方式搭配高效能散热模块,研制出了72W、80W的高亮度白光LED光源,如图7.1(a)所示。由于其封装热阻较低(4.38℃/W),当环境温度为25℃时,LED结温控制在60℃以下,从而确保了LED的使用寿命和良好的发光性能。华中科技大学则采用COB封装和微喷主动散热技术,封装出了220W和1500W的超大功率LED白光光源,如图7.1(b)所示。
3)封装大生产技术
晶片键合(Wafer Bonding)技术是指芯片结构和电路的制作、封装都在晶片上进行,封装完成后再进行切割,形成单个的芯片;与之相对应的芯片键合是指芯片结构和电路在晶片上完成后,即进行切割后形成芯片,然后对单个芯片进行封装(类似现在的LED封装工艺),如图7.2所示。很明显,晶片键合封装的效率更高、质量更好。由于封装费用在LED器件制造成本中占了很大比例,因此,改变现有的LED封装形式(从芯片键合到晶片键合),将大大降低封装制造成本。此外,晶片键合封装还可以提高LED器件生产的洁净度,防止键合前的划片、分片工艺对器件结构的破坏,提高封装成品率和可靠性,因而是一种降低封装成本的有效手段。
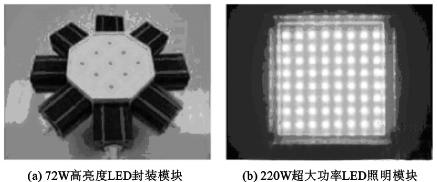
图7.1 高亮度和超大功率LED照明模块
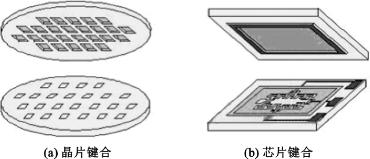
图7.2 晶片键合和芯片键合封装示意图
此外,对大功率LED封装,必须在芯片设计和封装设计过程中,尽可能采用工艺较少的封装形式,同时简化封装结构,尽可能减少热学和光学的界面数,以降低封装热阻,提高出光效率。
7.2 LED封装原材料及工艺流程单
本节主要介绍LED封装的原材料及LED封装工艺流程单的识读,这是LED封装各岗位工作人员必备的知识。
7.2.1 LED封装中的芯片和支架简介
LED的原材料包括芯片、支架、金线、银胶、硅胶、透镜等。本节主要介绍芯片和支架这两种跨越LED封装整个工序的主要原材料,其余原材料在各章的相关工序中介绍。
1.LED芯片厂商与型号
LED芯片的原理、结构与制造工艺前面已介绍过,本节主要介绍LED芯片厂商与型号的基本知识。如前所述,LED芯片厂商以国外和中国台湾地区为主,国内LED芯片制造领域近年来也取得了较大的发展,主要的芯片生产厂商如下。
1)国外LED芯片厂商
国外LED芯片厂商有CREE、安捷伦、日亚化学(Nichia)、丰田合成、大洋日酸、东芝、昭和电工(SDK)、Lumileds、旭明(Smileds)、Genelite、欧司朗(Osram)、GeLcore、首尔半导体、普瑞、韩国安萤(Epivalley),等等。
(1)CREE。其为著名的LED芯片制造商,产品以碳化硅(SiC)、氮化镓(GaN)、硅(Si)及相关的化合物为基础,包括蓝、绿、紫外发光二极管(LED),近紫外激光,射频(RF)及微波器件。功率开关器件适用于生产及科研的碳化硅(SiC)外延片。
(2)欧司朗。它是世界第二大光电半导体制造商,产品有照明、传感器和影像处理器。公司总部位于德国,研发和制造基地在马来西亚,约有3400名员工,2004年年销售额为45.9亿欧元。欧司朗最出名的产品是LED,长度仅几毫米,有多种颜色。其产品具有低功耗、寿命长等特点。
(3)日亚化学。其为日本著名的LED芯片制造商,成立于1956年,目前已在世界各地建有子公司。该制造商于1993年开发出了世界第一颗蓝色LED,于1995年开发出了世界第一颗纯绿LED。
(4)丰田合成。它的总部位于日本爱知,主要生产汽车部件和LED,其中LED约占其总收入的10%。丰田合成与东芝所共同开发的白光LED,采用的是紫外光LED与荧光体组合的方式,与一般蓝光LED与荧光体组合的方式不同。
(5)安捷伦。安捷伦作为世界领先的LED供应商,其产品为汽车、电子信息板及交通信号灯、工业设备、蜂窝电话及消费产品等提供高效、可靠的光源。这些元件的高可靠性通常可保证在设备使用寿命期间无需更换光源。安捷伦低成本的点阵LED显示器、品种繁多的七段码显示器及LED光条系列产品都有多种封装及颜色供选择。
(6)东芝。东芝是汽车用LED的主要供货商,特别是仪表盘背光、车载电台、导航系统、气候控制等。使用的技术是InGaAlP,波长从560nm(puregreen)到630nm(red)。近期,东芝开发了新技术UV+phosphor(紫外+荧光),LED芯片可发出紫外线,激发荧光粉后组合发出各种光,如白光、粉红、青绿等。
(7)Lumileds。Lumileds(飞利浦流明)是全球大功率LED和固体照明的领导厂商,其产品广泛用于照明、电视、交通信号和通用照明。Luxeon Power Light Sources是其专利产品,它结合了传统灯具和LED的小尺寸、长寿命的特点,还提供各种LED晶片和LED封装,有红、绿、蓝、琥珀、白等LED。它的总部设在美国,工厂位于荷兰、日本、马来西亚,由安捷伦和飞利浦合资组建于1999年。2005年,飞利浦完全收购该公司。
(8)首尔半导体。首尔半导体是韩国最大的LED环保照明技术生产商,并且是全球八大生产商之一。首尔半导体的主要业务为生产全线LED组装及定制模组产品,包括采用交流电驱动的半导体光源产品,如Acriche、侧光LED、顶光LED、切片LED、插件LED及食人鱼(超强光)LED等。产品已广泛应用于一般照明、显示屏照明、移动电话背光源、电视、便携式计算机、汽车照明、家居用品及交通信号等。
2)中国台湾地区LED芯片厂商
中国台湾地区LED芯片厂商主要有晶元光电(Epistar,简称ES)、广镓光电(Huga)、新世纪(Genesis Photonics)、华上(Arima Optoel ectronics,简称AOC)、泰谷光电(Tekcore)、奇力、钜新、光宏、晶发、视创、洲磊、联胜(HPO)、汉光(HL)、光磊(ED)、鼎元(Tyntek,简称TK)、曜富洲技TC、灿圆(FormosaEpitaxy)、国通、联鼎、全新光电(VPEC)、华兴(Led techElectronics)、东贝(Unity Opto Technology)、光鼎(ParaLight Electronics)、亿光(Everlight Electronics)、佰鸿(Bright LED Electronics)、今台(Kingbright)、菱生精密(Lingsen Precision Industries)、立基(Ligitek Electronics)、光宝(Lite-OnTechnology)、宏齐(HARVATEK)等。
3)内地LED芯片厂商
内地LED芯片厂商主要有三安光电(简称S)、上海蓝光(Epilight,简称E)、士兰明芯(SL)、大连路美(简称LM)、迪源光电、华灿光电、南昌欣磊、上海金桥大晨、河北立德、河北汇能、深圳奥伦德、深圳世纪晶源、广州普光、扬州华夏集成、甘肃新天电公司、东莞福地电子材料、清芯光电、晶能光电、中微光电子、乾照光电、晶达光电、深圳方大、山东华光、上海蓝宝等。
4)芯片型号与特性示例
了解芯片的型号与特性是LED封装岗位的基本要求,由于LED芯片的命名规则因厂商不同而有所不同,并未形成完全统一的规则。以下以某LED封装企业中作为原料的芯片产品标签为例,说明其特性,如图7.3所示。

图7.3 中国台湾地区华新丽华公司的LED芯片产品标签
图7.3中,左上角是产品的商标、型号及条码等信息;右边中部的RoHS是由欧盟立法制定的一项强制性标准,它的全称是《关于限制在电子电器设备中使用某些有害成分的指令》(Restriction of Hazardous Substances),该标准于2006年7月1日开始正式实施,主要用于规范电子电气产品的材料及工艺标准,使之更加有利于人体健康及环境保护。标签的下半部分分别为功率、正向压降以及主波长的出厂测试参数,分别列出了测试的最小值、平均值、最大值及标准差。由图可见,该芯片是采用350mA恒流电源驱动的大功率蓝光芯片。
2.LED支架简介
1)LED支架的作用及组成
(1)支架的作用。支架用于导电和支撑。
(2)支架的组成。支架从里到外分别由素材、铜、镍、铜、银等五层组成。直插式支架一般为铜材度银,贴片式;大功率支架一般采用铜材度银结构加塑胶反射杯,铜材起连接电路、反射、焊接等作用,塑胶主要起反射、提供与胶水结合等作用。在支架的众多因素中,除冲压件的设计和性质外,白色高温塑胶料是影响LED质量和稳定性的一个重要因素。用于SMD支架的塑胶料主要是白色PPA材料(中文名为聚对苯二酰对苯二胺,半结晶性材料,HDT(热液白云岩)约为300°,Tm(溶解温度)约为320°,它为一种芳香族的高温尼龙,但吸水较普通尼龙小得多),具有耐高温焊接、高反射、与硅胶的结合性好、长期性耐度不错等特点。
2)支架的种类
LED支架一般有直插式LED支架、食人鱼LED支架、贴片式LED支架和大功率LED支架。从光学结构看,LED支架可分为带杯支架和平头支架,分别适用于封装小角度聚光型LED和大角度散光型LED。
直插式LED支架的分类如下。
(1)2002杯/平头:此种支架的材料一般对角度、亮度要求不是很高,其Pin长比其他支架要短10mm左右,Pin间距为2.28mm。
(2)2003杯/平头:用来做φ5以上的Lamp,外露Pin长为+29mm、-27mm,Pin间距为2.54mm。
(3)2004杯/平头:用来做φ3左右的Lamp,Pin长及间距同2003杯/平头。
(4)2004LD/DD:用来做蓝、白、纯绿、紫色的Lamp,可焊双线,杯较深。
(5)2006:两极均为平头型,用来做闪烁Lamp,固IC,焊多条线。
(6)2009:用来做双色的Lamp,杯内可固两颗晶片,三支Pin脚控制极性。
(7)2009-8/3009:用来做三色的Lamp,杯内可固三颗晶片,四支Pin脚。
(8)724-B/724-C:用来做食人鱼的支架。
贴片式LED支架可分为顶部发光和侧发光两种;而大功率LED支架是采用贴片式的结构。目前,市场常用的贴片式LED支架规格有如下几类。
(1)顶部发光:3528、5050、3020、3014。
(2)侧发光:335、008、020、010。
3)支架品牌举例
目前,我国制作大功率LED支架最专业、最具规模的厂商均在广东省东莞市,东莞市是我国LED支架行业的发源地。其最具规模、性价比最高、品质最稳定的支架厂商有亿润、鑫亮光电、宏磊达等。亿润和宏磊达的产品非常杂,鑫亮光电产品较齐全。
7.2.2 LED封装企业生产流程单简介
生产流程单的识读是LED封装岗位任务的基本要求。其内容包括了解各种原物料的特性及型号、了解所在企业的产品命名规则等相关知识。根据企业规模、管理方式的不同,可能会有一定的差别。以下以某LED封装企业的产品命名规则和纸质生产流程单为例进行介绍。
1.LED灯珠产品命名规则
表7.1所示的是某公司生产的大功率LED灯珠产品命名规则,其中有些参数是行业通用的,有些是企业自己确定的。
表7.1 大功率LED灯珠产品命名规则示例

续表

2.LED封装生产流程单
了解了所在企业的产品命名规则后,结合原材料的知识,可以识读生产流程单,或称生产指令单。图7.4所示的为某大功率LED企业的生产指令单,在某一批次的生产任务确定后,生产管理人员会把生产指令单复制若干份,同时发放到封装生产线的各个岗位,各岗位操作人员按照指令单指示进行正确的操作。一般而言,生产指令单标明了产品型号、采用的原材料型号、产品性能规格等参数。其中有些参数是需要在某些岗位进行设置的,例如,色温的要求是配粉时粉量检测的依据,也是分光时的检测标准。

图7.4 LED封装生产指令单示例
一般而言,下达生产指令单的同时还要下达一张跟随产品在各岗位流动的物料跟踪单,跟踪和反馈生产过程中物料的使用情况,如有无丢失或损坏等。
7.3 LED封装中的静电防范
LED封装中要特别注意防范静电,即防止静电对LED封装生产中的元件尤其是芯片产生的危害。
7.3.1 静电的产生
静电学是18世纪以库仑定律为基础建立起来的,是研究静止电荷及磁场作用规律的一门学科,是物理学中电磁学的一个重要组成部分。
任何两个不同材质的物体接触后再分离,即可产生静电。两个不同的物体相互接触会使一个物体失去一些电荷,如电子转移到一个物体使其带正电,而另一个物体得到一些剩余电子使其带负电。所以物体接触后再分离就会带上静电。通常从一个物体上剥离一张塑料薄膜时就是一种典型的“接触分离”起电。
固体、液体甚至气体都会因接触分离而带上静电。为什么气体也会产生静电?因为气体是由分子、原子组成的,当空气流动时,分子、原子也会发生接触分离而起电。
实质上,摩擦起电是一种接触又分离而造成正负电荷不平衡的过程。摩擦是一个不断接触与分离的过程。因此摩擦起电实质上是接触分离起电。在日常生活中,各类物体都会因移动或摩擦而产生静电,如工作桌面、地板、椅子、衣服、纸张、包装袋、流动空气等。
另一种常见的起电是感应起电,当带电物体接近不带电物体时,会在不带电物体的两端分别感应出正电与负电。
7.3.2 静电的特性及其对电子元器件的危害
静电的物理特性为:同极相斥、异极相吸,与大地有电位差,会产生放电电流而危害LED等电子产品。
ESD是Electro Static Discharge的英文缩写,即静电放电的意思。ESD是20世纪中期用来研究静电的产生与衰减、静电放电模型、静电放电效应如电流热(火花)效应(如静电引起的着火与爆炸)和电磁效应如电磁干扰(EMI)及电磁兼容性(EMC)等问题。
静电时时刻刻存在,但是,20世纪40—50年代很少有静电问题,因为那时的晶体三极管和晶体二极管所产生的静电不如现在普遍。20世纪60年代,随着MOS器件的出现,静电问题日渐明显,到20世纪70年代静电问题越来越严重。20世纪80—90年代,随着集成电路越来越密集,一方面其二氧化硅膜的厚度越来越薄,其承受的静电电压越来越低;另一方面,由于大量使用塑料、橡胶等静电材料,使得静电越来越普遍。
1.静电对电子产品损害的特点
1)隐蔽性
人体不能直接感知静电,除非发生静电放电。但是,即使发生静电放电,人体也不一定能有电击的感觉,这是因为人体感知的静电具有隐蔽性。
2)潜在性
有些电子元器件受到静电损伤后的性能没有明显下降,但多次累加放电会给元器件造成内伤而形成隐患。因此静电对元器件的损伤具有潜在性。
3)随机性
电子元器件在什么情况下会遭受静电破坏呢?从元器件产生到它损坏以前,所有的过程都会受到静电的威胁,而这些静电的产生具有随机性。
4)复杂性
静电放电损伤的失效分析工作,因电子产品的精、细、微小的结构特点而费时、费事、费钱,往往需要使用扫描电镜等高精密仪器。即便如此,有些静电损伤现象难以像其他原因造成的损伤失效一样当成其他失效。这在未充分认识静电放电损害之前,常常归因于早期失效或情况不明的失效,从而不自觉地掩盖了失效的真正原因。所以静电对电子元器件损伤的分析具有复杂性。
2.静电对LED芯片的影响
静电对LED芯片的影响主要体现在以下几方面。
(1)静电放电破坏,使LED芯片等元器件受损坏(安全破坏)而不能工作。
(2)静电放电或电流产生的热,使LED芯片等元器件受到损伤(潜在损伤)。
(3)静电放电产生的电磁场幅度很大(达几百伏/米)、频谱极宽(从几十兆到几千兆),对LED芯片等元器件造成干扰甚至损坏(电磁干扰)。
如果元器件损坏,则能在生产及品管中被察觉而排除,影响较小。如果是静电使元器件轻微受损,在正常测试下不易发现,并会因过多层的加工,直至已在使用时才出现,不但检查不易,还要耗费很多人力及财力才能查出问题,且造成的损失将可能巨大。
静电对高亮度LED在使用上存在的影响是非常大的。静电是造成LED材料漏电(IR/反向电流)的主要因素,LED在漏电后其亮度和颜色不会即时表现出不良现象,但持久工作时其亮度会明显下降或不稳定及不亮,因此要重视和采取防范措施。
3.静电的防范措施
90%的静电危害均来源于作业中没有对设备进行接地及操作人员没有配备相应的防静电设置,因而在制造作业中应尽可能地在防静电方面进行一些控制。
1)原物料检验环节
(1)测试机台需接地(单独地线)。
(2)测试人员需配备防静电环(必须为有线并接单独地线)。
(3)避免材料有剧烈摩擦,如在材料盘内来回挪动材料及在桌面上反复挪动材料均易造成漏电。
2)仓库储存
(1)储存条件:温度保持在(25±5)℃,湿度保持在60%以下。
(2)将元器件包装好,杜绝12h内不封口现象。
3)封装生产过程
(1)生产车间地板布铜网进行静电吸收处理(单独地线)。
(2)焊接设备(包括电烙铁、自动焊接机台及测试机台)需接地。
(3)操作人员需配备防静电环。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。















