3.3 7次光刻的简要回顾
最早的第1代生产线采用的是7次光刻。这项技术一直延续到第4代生产线。对7次光刻的理解是建立TFT制作技术的基础。7次光刻形成TFT阵列需14个步骤,叙述如下。



第1步,制作金属电极栅极和存储电容电极。
●清洗与镀金属膜工艺:首先是玻璃基板投入,清洗、干燥工艺,用清洗机清洗玻璃基板,并烘干,如图3.5所示;开始溅射金属膜,作为栅极材料,金属一般采用合金,有时甚至采用双层合金膜。
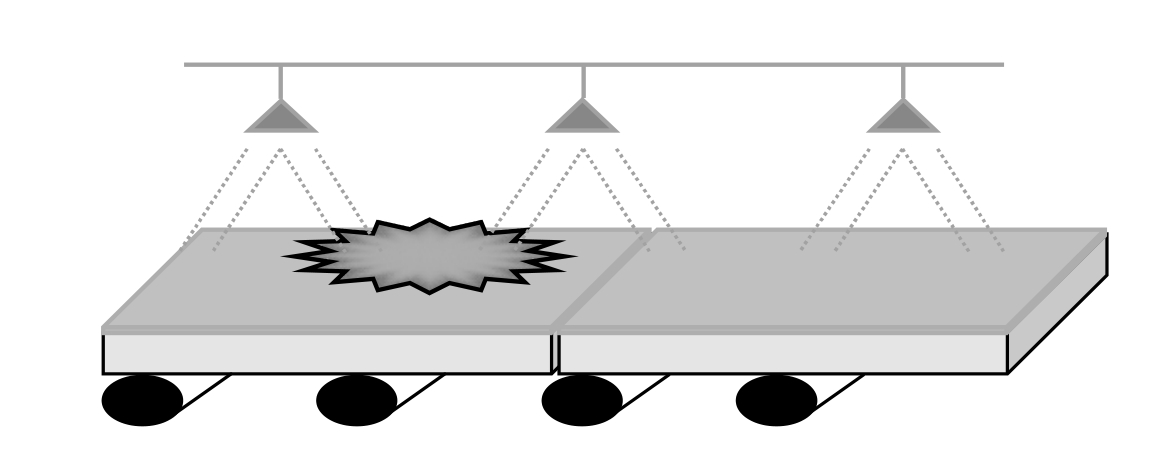
图3.5 用清洗机清洗金属膜玻璃基板
●涂胶工艺:用涂胶机在处理好的金属膜上涂敷紫外(ultraviole,UV)感光的光刻胶,见图3.6。光刻胶膜厚度一般控制在(15 000±500)左右。第4代生产线以下的生产线都采用旋转涂胶工艺。
●光刻胶固化工艺:前烘工艺、高温烘焙、固化光刻胶。
●曝光工艺:紫外线通过具有栅极图形的掩模板照射光刻胶。有图形的部分挡住UV光,如图3.7所示,被紫外光照射的光刻胶就变软(称为正性光刻胶,被紫外光照射后变硬的称为负性光刻胶)。
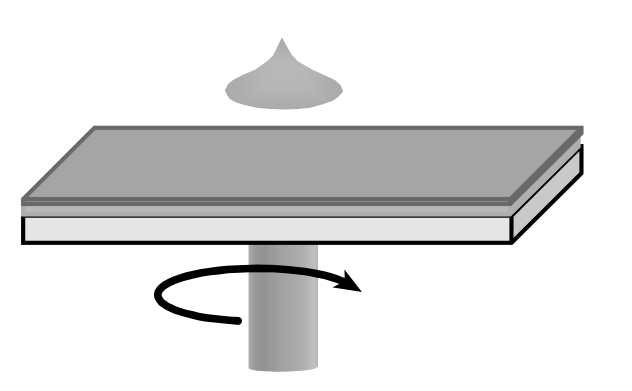
图3.6 涂敷光刻胶
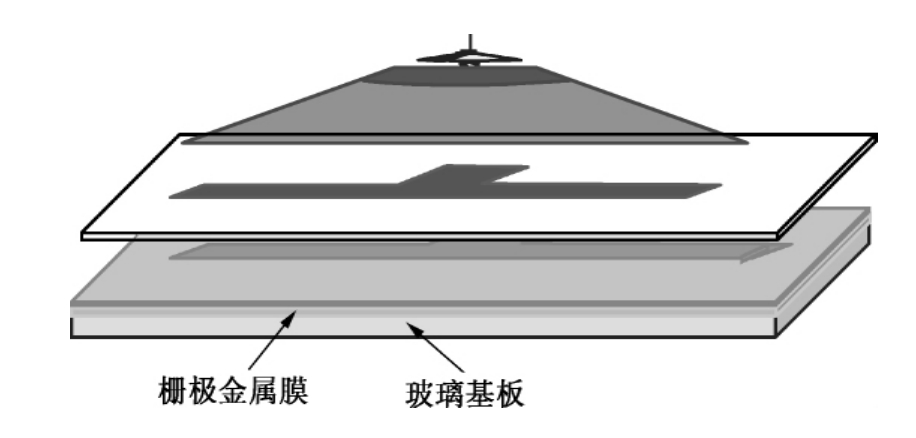
图3.7 曝光原理
●显影工艺:除去光刻胶的软化部分,用显影液处理,如图3.8所示。

图3.8 显影原理
●后烘工艺:对经显影处理的玻璃基板进行高温烘焙。
●刻蚀工艺:有湿刻和干刻两种工艺。湿刻是用腐蚀液进行处理,如图3.9所示,除去不需要的金属。干刻是用减压下的气体放电,使之反应形成气态的处理,如图3.10所示。
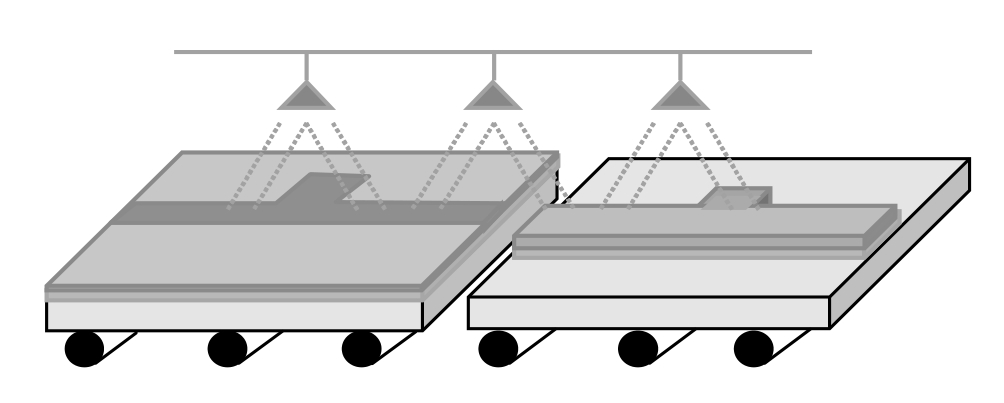
图3.9 湿法刻蚀原理
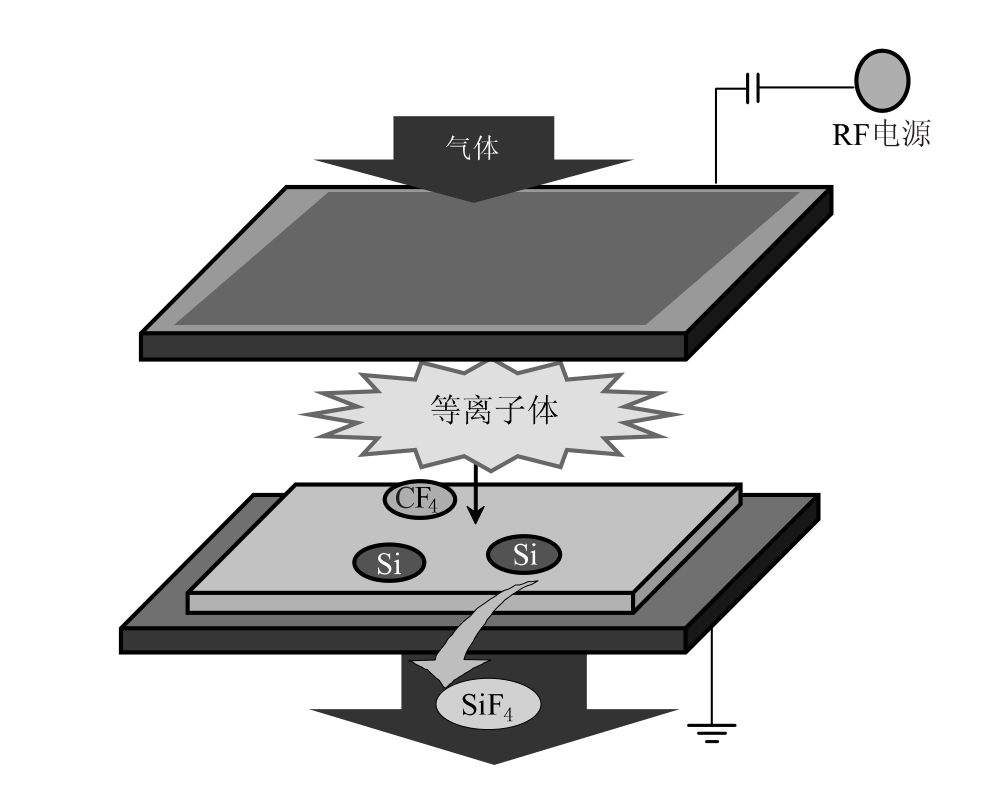
图3.10 干刻原理
●剥离工艺:剥离工艺分湿法剥离和干法剥离。湿法剥离如图3.11所示,是用剥离液除去形成图形时使用的光刻胶。干法剥离是在减压条件下用氧气放电的方式使光刻胶氧化,形成气体状态而被除去,或用臭氧和UV照射使光刻胶氧化形成挥发态气体而被除去,这个工序也叫氧气或UV灰化工艺。
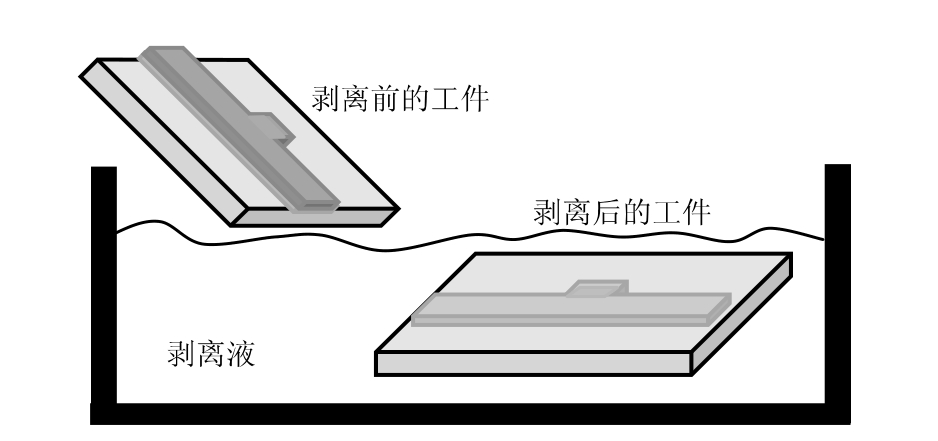
图3.11 剥离原理
至此,栅极图形已经形成,如图3.12所示,一个完整的光刻过程已经结束。下面重复以上过程完成其他薄膜层的制作。
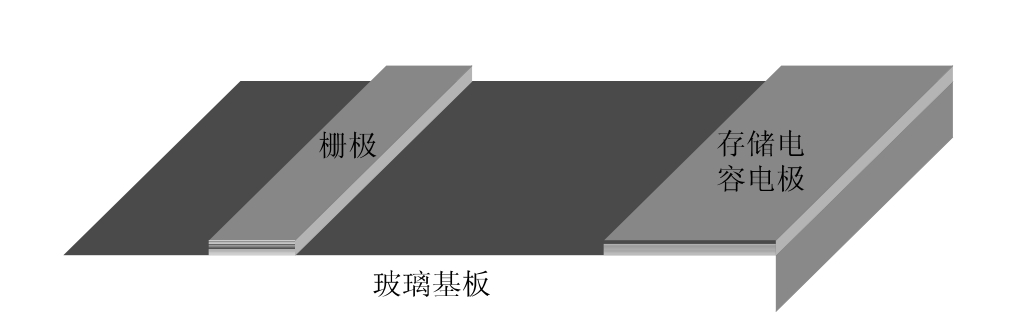
图3.12 第1次光刻形成的栅极和存储电容电极
第2步,制作SiOx绝缘层。
SiOxCVD工艺:采用CVD或PECVD技术形成栅极绝缘层膜(SiOx或SiNx),如图3.13所示。这层膜是栅极和有源层半导体膜(非晶硅,简写为a-Si)的界面,是决定薄膜晶体管特性的重要工艺。
第3步,为了提高膜的质量,在SiOx膜上增加一层SiNx,这个工艺过程和第2步完全相同。许多厂家的这一步骤已经省略了。
第4步,制作非晶硅膜。
CVD制备a-Si膜工艺:用CVD技术生长半导体膜(a-Si),如图3.14、图3.15所示。
第5步,第2次光刻:形成TFT有源层的图形,如图3.16所示。
第6步,制作n+a-Si膜:为了与源极和漏极金属电极形成良好的欧姆接触,以及防止反向电场下的漏电流,少量添加磷(n+),形成有源层的n+a-Si膜,如图3.17所示。
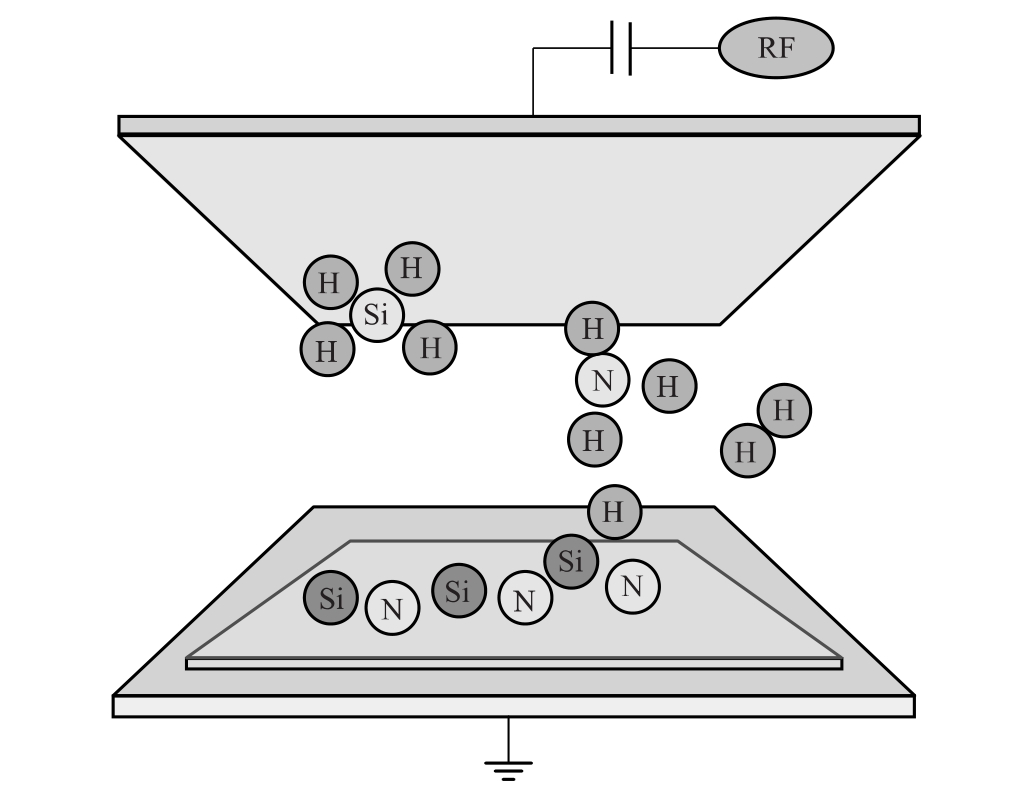
图3.13 PECVD沉积绝缘层SiNx
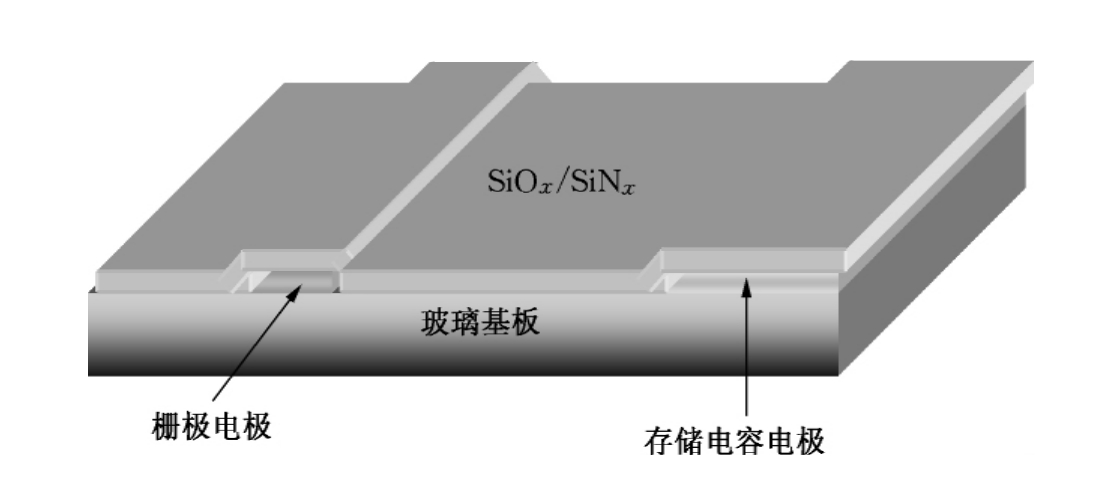
图3.14 PECVD沉积SiOx和SiNx膜示意
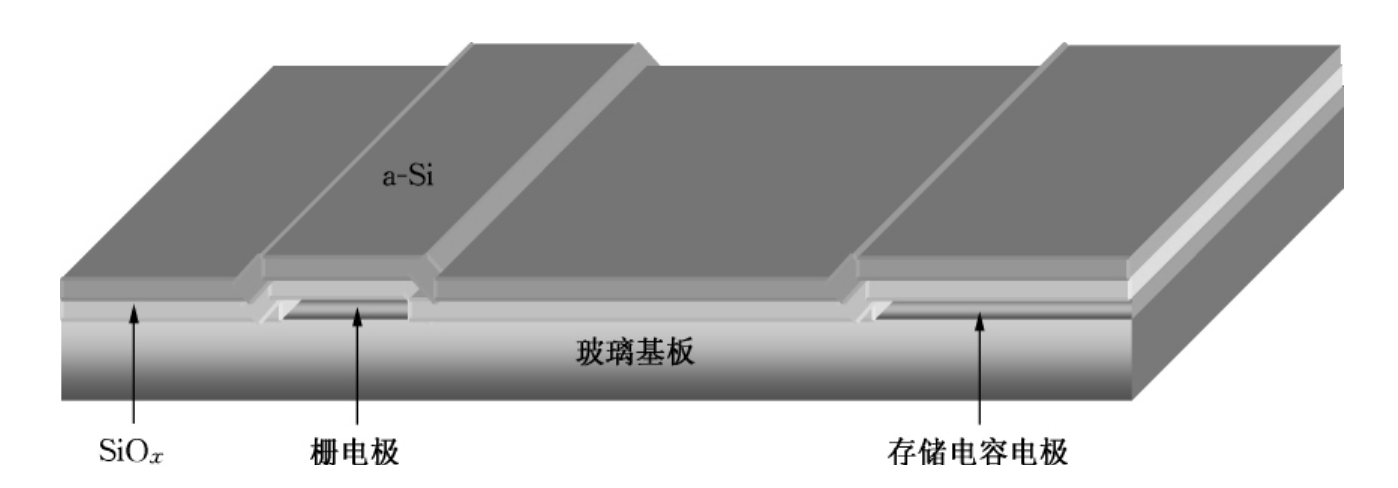
图3.15 制作非晶硅膜
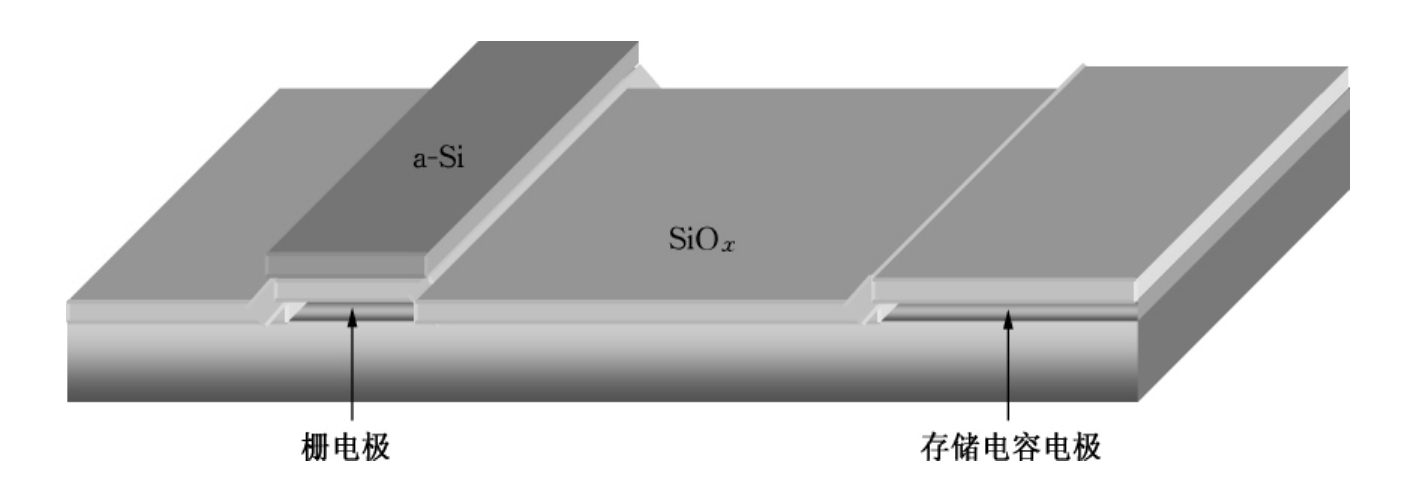
图3.16 光刻以后的有源层图形
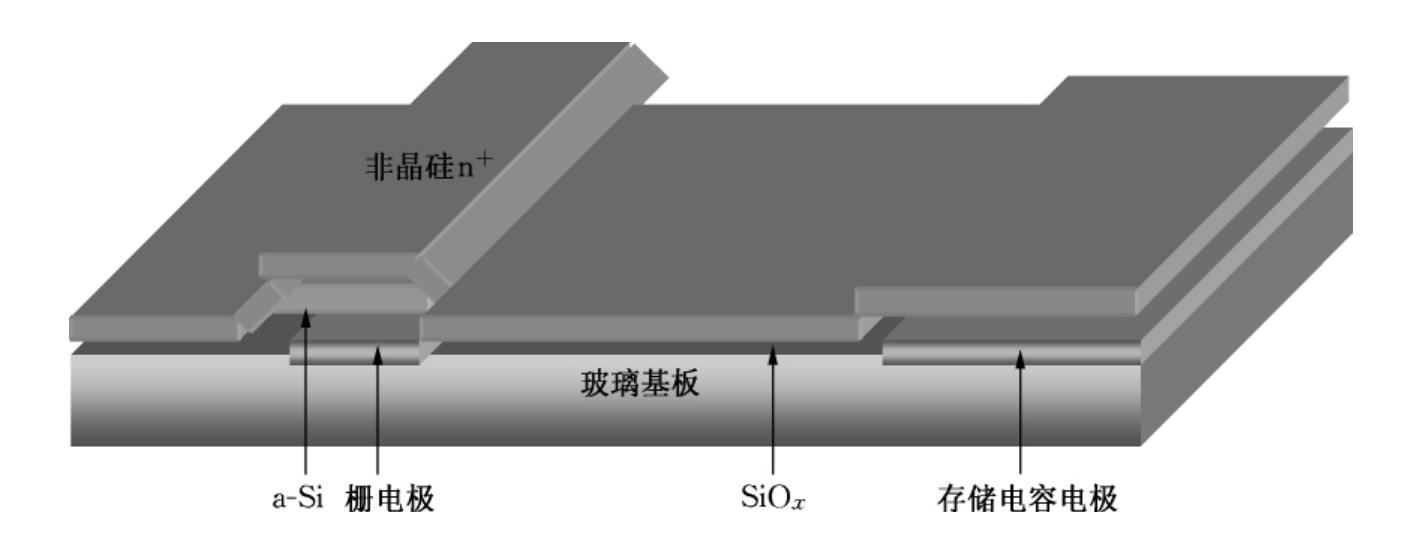
图3.17 沉积n+a-Si膜
第7步,第3次光刻形成非晶硅n+图形,如图3.18所示。
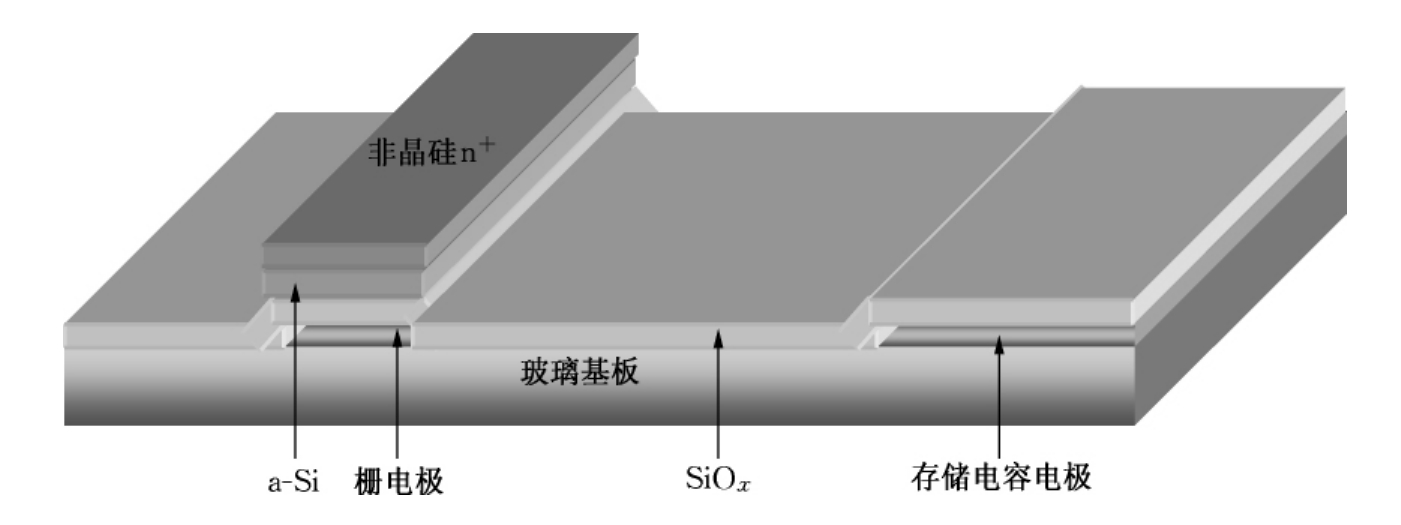
图3.18 制作有源层非晶硅和n+非晶硅膜图形
第8步,ITO溅射工艺:溅射透明导电膜即氧化铟氧化锡膜制做像素电极。
第9步,第4次光刻:形成像素电极(透明电极,ITO)图形,如图3.19所示。
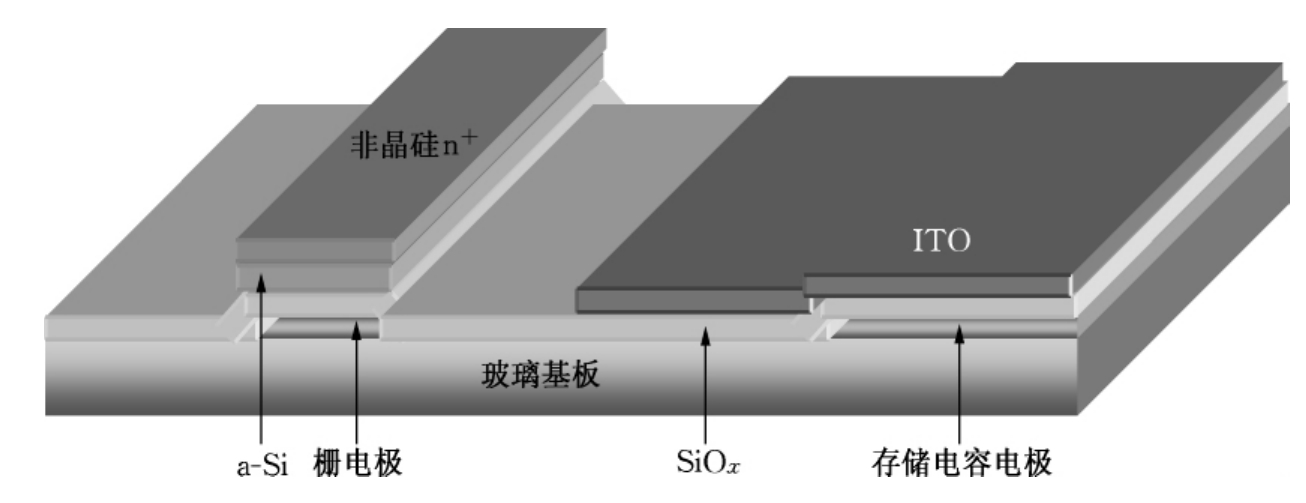
图3.19 形成像素电极以后的结构
第10步,第5次光刻:将存储电容CS上的栅极氧化膜的一部分去掉,形成CS的引线电极,如图3.20所示。

图3.20 5次光刻以后的效果
第11步,溅射铝工艺:溅射铝(Al)或钛(Ti)等金属制作TFT的漏电极、源电极,如图3.21所示。
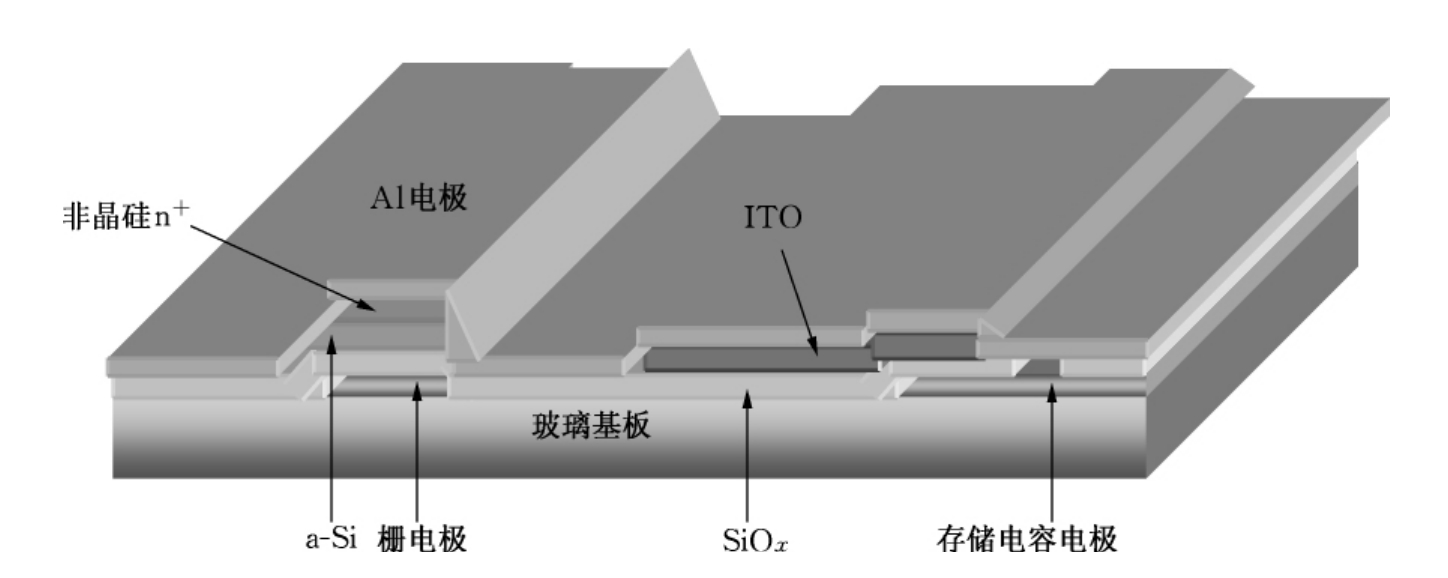
图3.21 制作Al电极
第12步,第6次光刻:做出各电极图形,如图3.22所示。
图3.22 6次光刻以后的效果
第13步,用CVD法生长氮化硅等保护膜,保护TFT等元器件。
第14步,第7次光刻:形成保护膜的图形,如图3.23所示。

图3.23 第7次光刻以后的效果
通过7次光刻我们形成了完整的TFT阵列。经特性检测后,阵列(TFT)就完成了。如图3.24所示,这里TFT在每个像素的角上。TFT在整个像素面积中占的面积比例越小越好。图3.24的左边是一个示意图,其右边是等效原理图。早期TFT生产线制作的TFT存储电容电极为分立的较多。现在的生产线制作的TFT存储电容电极一般都和栅极共线,这样可以简化工艺,减低成本,如图3.25所示。
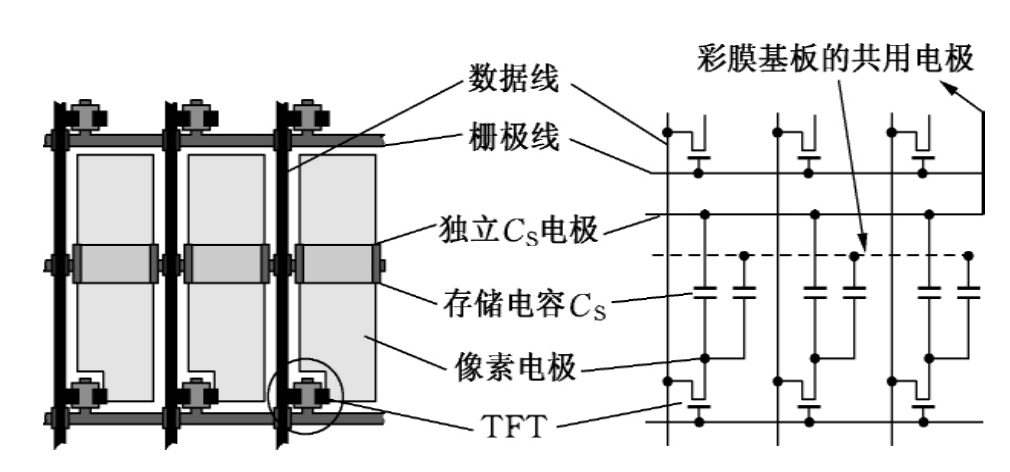
图3.24 存储电容电极分立的TFT结构示意图和等效电路
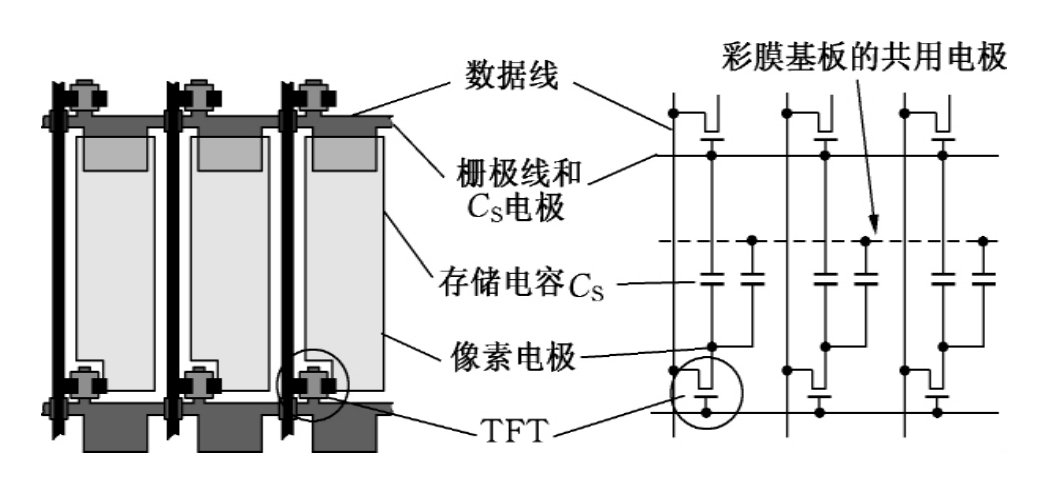
图3.25 存储电容电极共栅极的TFT结构示意和等效电路
早期TFT生产线制作的TFT的信号线宽为5μm,栅线线宽为11μm,ITO和栅线、信号线的距离是4μm,刻蚀精度是2μm,曝光精度是4μm±0.5μm。今天TFT生产线和TFT的制造技术都有了巨大的进步。线宽、器件材料和器件图形都有了进步。如图3.26所示,栅极材料和图形的改进提高了TFT的电学性能和稳定性。
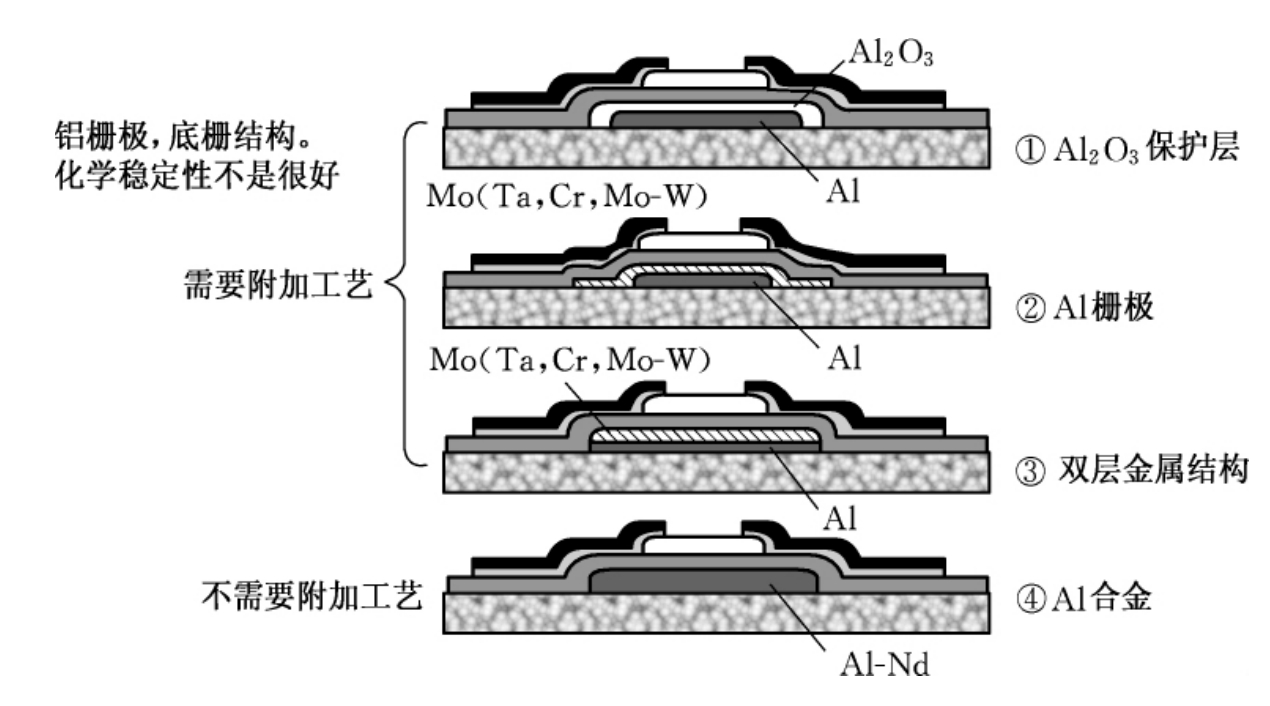
图3.26 栅极材料和图形的改进
7次光刻的TFT的阵列工艺流程简单归纳如图3.27所示。
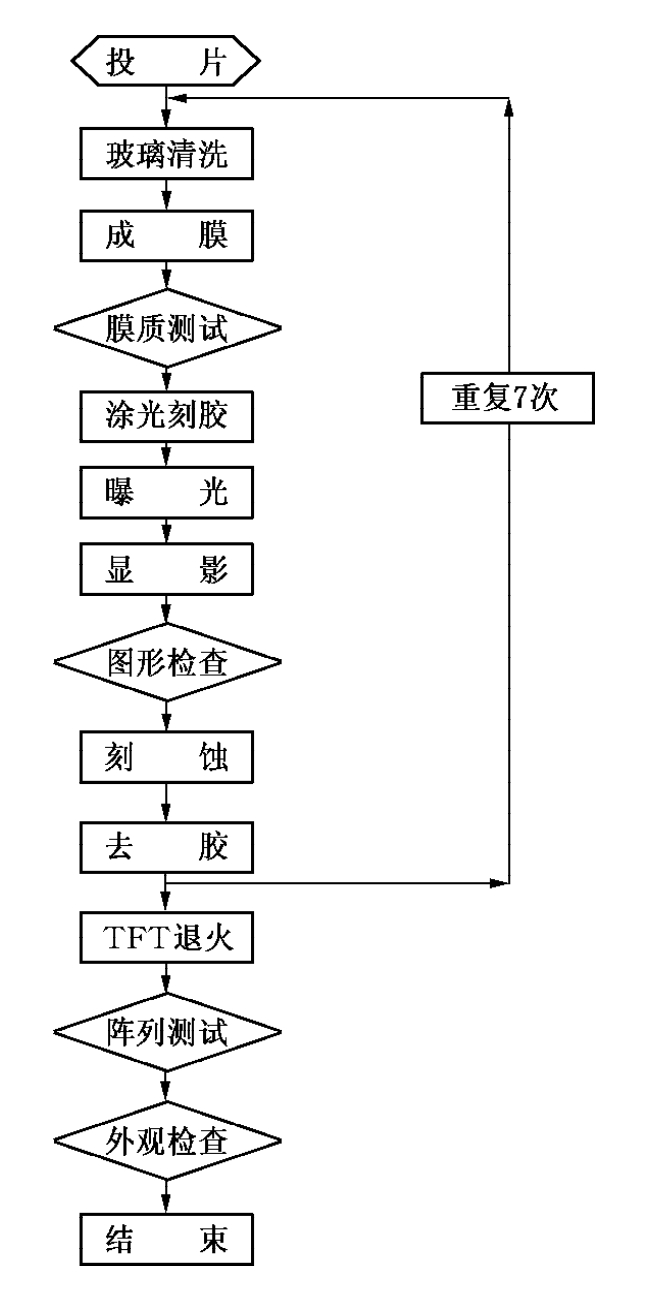
图3.27 7次光刻的TFT阵列光刻工艺流程
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。















