早期对纳米线光电导体的高光导增益的研究兴趣源于其所固有的大的表面-体积比。目前,利用纳米线异质结构实现集成光子回路中的高效光电转换成为研究热点。下面介绍光电探测器中较有前景的纳米线异质结构,包括同质、异质、肖特基结光电二极管和雪崩光电探测器,如图5.17所示。

图5.17 纳米线的结构[47]
1.同质和异质光电二极管结
光电二极管结(如半导体pn或pin光电二极管)可以成功应用到纳米线结构中,其中同-异质结在纳米线生长过程中直接形成(自下而上的方法)或在纳米线制备之前形成(自上而下的方法)。最近,工作在光伏模式下的纳米线光电二极管引起了人们的浓厚兴趣。单根纳米线太阳能电池已经在同质结(如GaAs径向p-i-n结和GaAsP径向p-i-n结)、GaAs/InGaP/GaAs核-壳异质结和肖特基接触GaAs纳米线。目前垂直纳米线阵列异质结(如n-GaAs纳米线/n+-Si、n-InAs/p-Si)和垂直纳米线阵列的同质和异质结(如InP衬底上的轴向InP p-n结、Si衬底上的n核/p壳GaAsP n-p结、n-GaAs衬底上的n核/p壳GaAs纳米线,或透明导电氧化物衬底上的ZnO-核/ZnSe-壳纳米线)仍在不断探索中。下面重点介绍用于光电探测器应用的纳米线光电二极管结构。
p-n和p-i-n结构是用于同质和异质结纳米线光电二极管的最常见结构。p-n/p-i-n结通常工作在反向偏压下,从而具有最小暗电流。如图5.18所示,本征或电荷耗尽区附近的光子吸收产生的电子-空穴对(EHP)被内部电场分离并产生负光电流。外部反向偏压增加了结的势垒高度和电荷耗尽区的宽度,由于结电场的增加,产生了更高效的EHP分离。
轴向同质和异质结纳米线光电二极管均已实现。例如,基于轴向同质p-n结的单根GaN纳米线紫外光探测器表现出整流特性、较快的光响应以及在0.03V反向偏压下约为14的光电导增幅。此外基于GaN纳米线p-i-n结的纳米线阵列光探测器也已实现。与在响应速度、线性功率和探测率方面表现良好的薄膜GaN p-i-n探测器相比,p-i-n结纳米线光电二极管具有较慢的响应速度、非线性的功率依赖性,并且可能出现一定的内部增益。的确,对于轴向p-i-n结纳米线器件,p和n掺杂段呈现光导效应。由于表面态跃迁导致结区漏电流很大,这些光电导效应在偏置电压下成为主导。

图5.18 p-i-n光电二极管中生成光电流的能带图和原理
类似地,77K温度下单根InAs/InAsP纳米线轴向异质结红外光电探测器具有极低的暗电流(由于在纳米线异质界面形成导带偏移)、强的偏振依赖性以及InAs(0.5eV左右开启)和InAsP部分(根据磷含量,在0.65~0.82eV内开启)对于光电导响应的组合贡献。在嵌有单个InAsP量子点的InP纳米线探测器中也观察到其对空间和线性偏振的高选择性,且具有4%的量子效率和10-13 W·Hz-1/2的NEP。
如前所述,核-壳纳米线结构在光伏中的应用引起了众多学者的兴趣。类似的设计理念也可以应用到更有效的光传感中,因为核-壳纳米线结构具有更有效的载流子分离,以及更好的光吸收等突出优势。目前GaAs系统的光响应已经被广泛研究,包括GaAs/AlGaAs核-壳和GaAs/InGaP/GaAs核-多壳纳米线。其中,基于核-壳GaAs/AlGaAs纳米线的近红外光电探测器在室温下具有与大面积平面商用GaA光电探测器相当的光响应峰值(0.57A·W-1),并且在λ=855nm时具有7.2×1010 cm·Hz1/2·W-1的高探测率。此外还提出了II型核-壳纳米线异质结构,其可以促进载流子分离,提高光敏性,增强光谱响应。用于可见光到紫外波段的InGaN/GaN核-壳p-i-n二极管也已实现,如图5.19所示[48]。图5.19(a)结构包括n型GaN核、用于吸收可见光的未掺杂InGaN径向部分和p掺杂GaN壳。n掺杂核在纳米线底部保持裸露状态,可以在无额外刻蚀的情况下实现与n层和p层的接触。如图5.19(b)所示,λ=400nm时探测器在零偏压下的响应度为0.075A·W-1。图5.19(c)为光电流谱,从对应于InGaN吸收层的2.8eV开始一直延伸到紫外光范围。

图5.19 纳米线光电探测器[48]
人们还研究了由垂直纳米线阵列和衬底形成的异质结光电探测器,其中大的纳米线密度对于增加光吸收区域,进而提升光导响应非常有利。特别地,由于可以采用很多方法(如化学气相沉积、溶剂热合成法或磁控溅射等)制备,人们在基于掺杂Si衬底的ZnO纳米线异质结光电探测器方面开展了大量研究工作。在这些结构中,根据纳米线的密度,顶部电极可以直接沉积在纳米线层上,或是使用透明填充材料(如旋涂玻璃或惰性聚合物)来减少漏电流。目前已经在p型或n型Si衬底上实现了本征掺杂n型ZnO纳米线,暗电流对施加偏压的依赖性类似于异质结的理想关系,具有典型的整流行为(Sze,1981):

其中Is是饱和电流,其他符号都代表其常用含义。n-ZnO纳米线/p-Si异质结探测器在紫外光照射和-20V偏压下的响应度约为0.07A·W-1,光生载流子动力学的快、慢分量分别在大约300ms和几分钟量级。有趣的是,通过施加正向或反向偏压,控制异质界面的能带偏移,选择性地收集Si衬底或ZnO纳米线中的光生载流子,可以使n-ZnO纳米线/p-Si异质结探测器的光谱灵敏度从可见光调到紫外波段。
类似地,基于p+-InP衬底上轴向n+-i-InP纳米线阵列的红外探测器也被证明具有优异的整流行为(室温下理想因子约为2.5,在-1V下具有小的漏电流)。室温下光电流主要通过光生载流子从衬底向纳米线中注入形成,而在低温下纳米线的直接激发起主导作用。有关n+-i-p+InP纳米线阵列的进一步实验表明,光生电流强烈依赖p+区的长度,形成限制在纳米线本征区的电场[249]。有关Si上III-V族纳米线直接外延生长的进展,为垂直纳米线阵列光电探测器和光伏器件的研究开辟了新的机会。
2.肖特基结
肖特基光电二极管使用金属/半导体结来分离和收集光生载流子。肖特基光电二极管的优点之一是响应速度快,这是由于在反向偏压下有跨结的高电场(因此有短的载流子输运时间)。理想肖特基二极管中的电流由式(5.16)给出,反向偏置饱和电流为:

其中,A*是理查森常数,φb是肖特基结势垒高度。为了解释与理想结果的偏差,将式(5.16)进一步修改为:

其中,Vth为正向偏置阈值电压,n是理想因子。当肖特基势垒n=1时,电流由热离子发射主导。
在半导体纳米线文献中,经常遇到金属-半导体界面上肖特基势垒影响光生载流子分离和输运的问题。特别地,可借助扫描光电流显微镜(SPCM)来研究纳米线光电探测器中的这些影响。在对CdS和CdSe纳米线进行的SPCM实验中,光电流-电压特性通常是不对称的,并且根据偏置条件,光电流被强烈局限于金属电极-纳米线接触面。利用SPCM技术可有效地研究纳米尺度的光电探测原理,例如,沿着纳米线轴的电子能带分布,确定载流子迁移率-寿命积,或分析纳米线的电子复合行为。
尽管对于纳米线器件中的金属半导体结的认识已经比较深入,但是对ZnO纳米线/纳米带、CdS纳米线/纳米带、SiC纳米线、GaN纳米线和InSb纳米线等材料在肖特基光电二极管中的研究一直处于探索阶段。
在非对称接触(即一个欧姆接触,一个肖特基接触)情况下,由于界面和表面态的影响,采用式(5.18)所得到的ZnO纳米线肖特基光电二极管的理想因子一般明显大于1。然而,也存在几乎理想的Pt/ZnO纳米线肖特基结光电二极管。
由贵金属(如Au、Ag和Pd)电极制成的对称两端纳米线器件通常为背对背肖特基二极管(金属-半导体-金属二极管,MSM)。在无光照条件下,热电子发射主要决定和限制MSM光电探测器的电流输运。在光照条件下,载流子密度的增加增强了金属/半导体界面肖特基势垒的隧穿概率,其中自建势对于载流子的分离和传输起着非常重要的作用,尤其是在反向偏置时。这种结构已经被应用于核-壳结构GaAs/高温GaAs/AlGaAs(40nm/170nm/30nm)纳米线中,其中Pt电极分别沉积在GaAs核和AlGaAs壳上。通过求解自洽薛定谔-泊松方程描绘纳米线横截面的电子分布,发现电子被限制在GaAs/AlGaAs异质界面,如图5.20(a)所示。相应的核-多壳纳米线结构如图5.20(b)所示,总半径约为240nm,横截面为六边形。图5.20(c)比较了无光照和低光照下的典型I-V特性。测得具有很低暗电流的非对称I-V曲线,暗电流受MSM结构中Pt/GaAs和Pt/AlGaAs之间不同肖特基势垒高度的限制。在这种情况下,暗电流被成功抑制。在光照条件下,发现光电流在电压范围为-1~1V时迅速增加,之后增加速率逐渐降低。当一个电极处于反向偏压时,其肖特基势垒高度增加,在电极处提供了更强的局部内建电场。因此,光生电子和空穴被该电场有效分离,光电流增加。最大电流受电极和GaAs/AlGaAs异质界面附近空间电荷区的载流子漂移,以及纳米线中性区内的扩散(载流子扩散长度和寿命)的限制。在GaAs核接地,AlGaAs壳施加-2V负偏压和2V正偏压时,可以产生最大为-0.8nA和0.62nA的电流。电流值的不同是由于Pt/AlGaAs界面比Pt/GaAs界面有更高的肖特基势垒,使得光电流与暗电流开/关比分外明显。图5.20(d)为测量的光响应谱,除了少量峰外,和典型的GaAs光电探测器类似。这表明吸收发生在GaAs核内,而不是AlGaAs壳中,且预示纳米线中存在光学谐振模式,使吸收增强。在λ=855nm时,响应度(定义为电输出与光输入的比率)为0.57A·W-1,高于商用GaAs光电探测器。探测率为7.2×1010 cm·Hz1/2·W-1,略低于平面GaAs光电探测器。可见,具有MSM结构的核-壳结构促进了径向电荷的分离,减弱了载流子的复合,从而增大了总光电流,证明了该设计在纳米线光电探测器中的可行性。类似地,笔者所在研究室制备出一种金属/单晶InP纳米线肖特基结光探测器,器件在中等偏压下的室温暗电流为10-10量级,在0.2mW/cm2、532nm激光照射下的最高响应度达6.8A/W。此外,本研究室还制备出一种石墨烯/GaAs纳米线阵列肖特基结光探测器,器件可在零偏压下工作,且具有较快的响应速度。

图5.20 核-多壳GaAs/AlGaAs纳米线[49]
3.雪崩光电二极管
雪崩光电二极管(APD)是纳米线光电探测器的一个最有趣的应用,当其工作在大的反向偏压下时,通过带间载流子碰撞电离引起的雪崩击穿能够使得每个光生载流子倍增。载流子累积使得光电二极管产生内部增益,从而增大器件的有效响应度。该过程的品质因数是倍增因子(或增益)M,表示从初始光生载流子中产生的载流子的平均数:
![]()
其中,δ是每个电子的平均电离次数,α和β分别是电子和空穴的场依赖电离速率。到目前为止,纳米线APD已经在3种不同的结构中得以实现,即“交叉”n-CdS/p-S纳米线异质结、单根Si纳米线轴向p-i-n结和嵌有InAsP量子点的轴向InP纳米线p-n结,以及径向GaAs纳米针结或径向GaAs p-n结。
在n-CdS/p-Si“交叉”APD中,由于p-n型交叉纳米线结的雪崩倍增效应,其光电流增幅(IPC/Idark)比单独n-CdS或p-Si纳米线光电导体高出104倍,其倍增因子高达7×104。在“交叉”结构中也可以观察到光响应的偏振依赖性,这是由于CdS纳米线中光吸收起主导作用。在轴向p-i-n Si纳米线APD中也得到了非常相似的结果(极化灵敏度、高空间分辨率和高灵敏度)。该结构在单根纳米线中实现互补掺杂,而不是两个不同掺杂的纳米线组装。该器件的最大倍增因子M=40。有趣的是,电子和空穴注入的倍增因子可以分离,表明由于较大的电子电离率(α>β),电子的倍增因子(Mn<100)大于空穴(Mp<20)。在具有单个InAsP量子点的InP纳米线中也观察到高倍增因子(>104),量子点作为唯一的吸收区域,能够产生隧穿单激子并实现载流子倍增。GaAs基APD首次在n-Si衬底上生长的径向p-n结GaAs纳米针中实现。光生载流子在纳米针和Si衬底中产生,随后被纳米针收集和倍增。雪崩倍增的原理是锥形纳米针内部具有高电场。在选区生长的径向p-n结GaAs纳米线阵列中采用了类似的电极结构,形成自对准的金属纳米孔晶格,通过表面等离激元布洛赫波模式增强吸收,如图5.21(a)、图5.21(b)所示。结中形成的三维受限电场在载流子的雪崩路径长度内,并作为倍增区,在-12V下、730nm处约有216的倍增增益,如图5.21(c)、图5.21(d)所示。
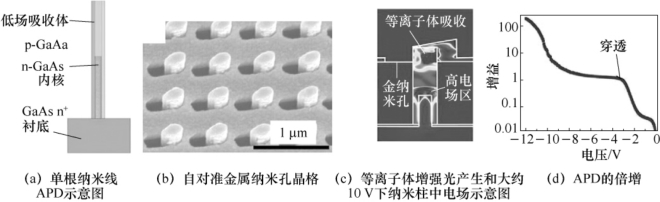
图5.21 雪崩光电二极管[50]
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。















